Description
OBIRCH is a non-destructive failure analysis technique used to locate open circuits, weak bonds, and resistive defects in semiconductor devices and PCBs. By scanning a laser or focused light beam across an energized device, localized heating alters the resistance at defective points. These changes are detected electrically, allowing precise identification of failure sites without damaging the component. OBIRCH is especially effective for identifying hidden electrical defects in packaged ICs and multilayer assemblies.
Applications
- Open Circuit Detection:Locate broken or weak electrical connections in ICs, PCBs, and wire bonds.
- Resistive Defect Analysis:Identify areas with abnormal resistance affecting device performance.
- Failure Localization:Pinpoint electrical failure sites for further microscopic or cross-sectional analysis.
- Quality Control:Verify electrical integrity of microelectronic assemblies and packaged devices.
- Reliability Testing:Evaluate susceptibility to weak connections or degraded interconnects over time.
- Research & Development:Support design verification, process improvement, and failure prevention studies.
- Microelectronic Inspection:Analyze multilayer ICs, flip-chips, and advanced packaging technologies without disassembly.

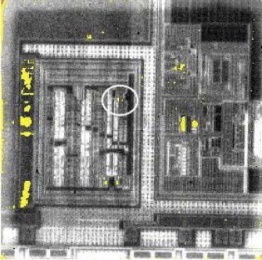

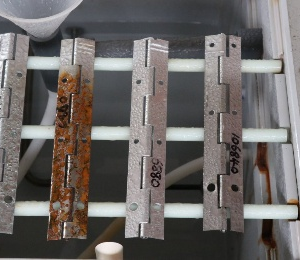




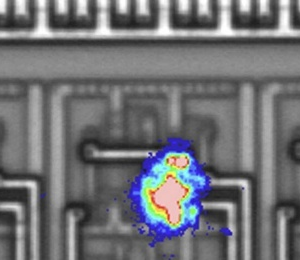

Reviews
There are no reviews yet.