Description
Focused Ion Beam (FIB) is a high-precision sample preparation technique that uses a finely focused ion beam to mill, cut, or deposit material on a microscopic scale. FIB is commonly used to prepare site-specific TEM lamellae, cross-sections, and microscale features with nanometer precision. This technique enables detailed structural and compositional analysis of advanced materials, electronic components, and nanostructures.
Applications
- TEM Lamella Preparation:Extract thin, site-specific samples for high-resolution TEM analysis.
- Cross-Sectioning:Create precise cross-sections of microelectronics, coatings, and multilayer structures.
- Nanostructure Fabrication & Analysis:Prepare and analyze nanoparticles, nanowires, and other micro/nano-scale structures.
- Failure Analysis:Investigate cracks, delamination, voids, and defects in metals, polymers, and composites.
- Semiconductors & Electronics:Study solder joints, interconnects, and internal device structures.
- Research & Development:Support advanced materials characterization, interface studies, and nanotechnology research.
- Site-Specific Analysis:Enable targeted preparation of areas of interest without damaging surrounding material.

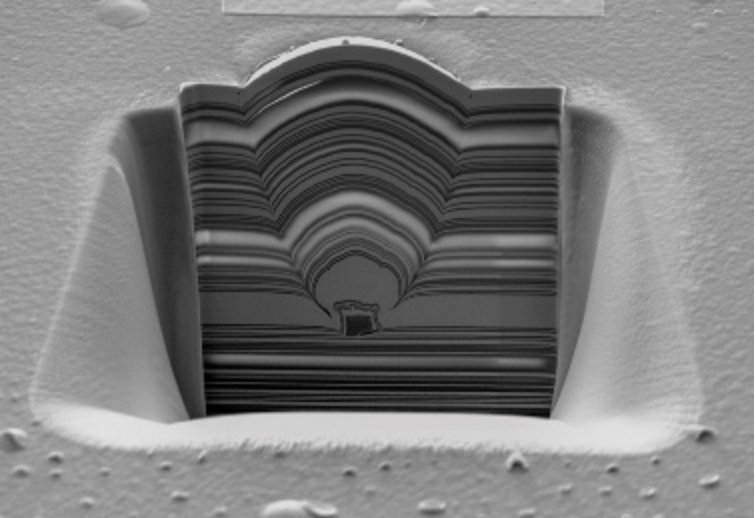





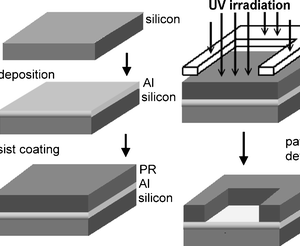
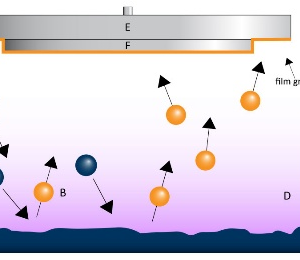
Reviews
There are no reviews yet.