Description
Time-of-Flight Secondary Ion Mass Spectrometry (TOF-SIMS) is a highly sensitive surface analysis technique that provides detailed information about the elemental and molecular composition of materials. By sputtering a sample surface with a focused ion beam and analyzing the ejected secondary ions, TOF-SIMS enables surface chemical mapping, depth profiling, and detection of trace elements at the nanometer scale.
Applications
- Surface Composition Analysis: Identify elements, isotopes, and molecular species on the outermost layers of materials.
- Chemical Mapping: Visualize spatial distribution of elements and molecules across surfaces.
- Trace Element & Contamination Detection: Detect low-concentration contaminants in coatings, polymers, and electronic components.
- Depth Profiling: Analyze compositional changes across thin films and multi-layered materials.
- Thin Films & Coatings: Study interfaces, layer uniformity, and surface treatments.
- Semiconductors & Electronics: Investigate impurities, dopants, and surface modifications in microelectronic devices.
- Materials Research & Development: Support design and optimization of functional surfaces, nanomaterials, and advanced coatings.


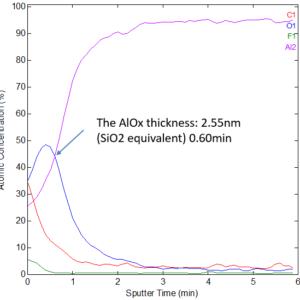


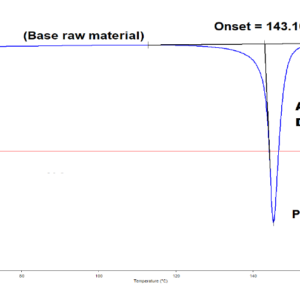
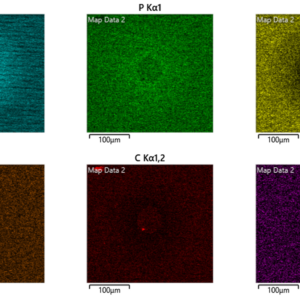

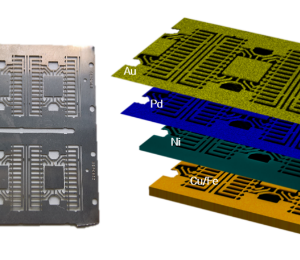



Reviews
There are no reviews yet.